台积电 (TSM.US)最近可谓动作不断,从提高先进制程价格,到进军“方形基板”。
最近,摩根士丹利发布了一份关于台积电的报告,详细总结了CoWos、PLP技术和3D SoIC的最新进展。
• CoWos封装:台积电预计,到2026年底,每月的CoWoS晶圆产能将达到约6万片;与先前披露的2024年底CoWoS封装产能将达到2.6-2.8万片/月相比,翻了一倍多;
• 面板级(PLP)封装:该技术与近期市场关注的“方形基板”相关。目前正在研发阶段,大规模量产还需数年时间;
• 3D SoIC封装:预计从2025年下半年开始增加产能,Rubin架构或采用3D SoIC封装技术。
一、CoWoS 产能更新
在最近的技术研讨会上,台积电表示:从2022年到2026年,CoWoS技术的产能预计将以超过60%的年复合增长率迅速增长。到2026年底,每月的CoWoS晶圆产能将达到约6万片。
目前,台积电的CoWoS月产能约为1.5万片,预计到2024年底,这一数字将提升至每月2.6-2.8万片。
同时,2024年全年,台积电计划投资280-320亿美元,其中约10%将用于先进封装技术。
摩根士丹利分析师指出,强劲的封装需求将成为未来几年台积电非晶圆收入快速增长的主要驱动力:
• 预计2023-2026年,台积电非晶圆收入的复合年增长率(CAGR)将达到31%;
• 到2023年,非晶圆销售有望占到台积电总收入的13%;
1)CoWoS-L封装
小摩指出,台积电正在加速其CoWoS技术的扩展,重点放在适应越来越大尺寸的AI芯片需求上,特别是CoWoS-L技术。
CoWoS封装技术现分为三种类型:CoWoS-S、CoWoS-R和CoWoS-L,它们的主要区别在于中介层的设计,这是连接芯片的关键层。
随着人工智能芯片尺寸的增加,先前使用硅中介层的CoWoS-S技术出现了良率问题。
为了应对这一挑战,台积电推出了CoWoS-L技术,采用了LSI+RDL中介层,有效解决了大尺寸芯片的良率问题。
小摩预计,未来台积电在CoWoS技术的发展将主要聚焦于CoWoS-L,以应对日益扩大的AI芯片面积需求。

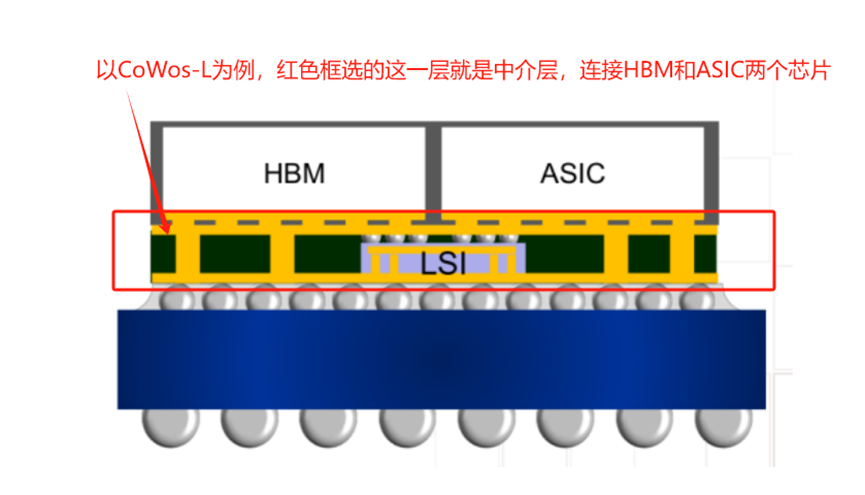
二、面板级(PLP)封装技术
小摩指出,台积电正在进行面板级(PLP)封装技术的研究,但大规模量产还需要几年时间。
PLP封装是一种将晶粒重新排列在更大的矩形面板上的封装方案(见下图左侧)。
目前,台积电使用的是圆形晶圆基板,这导致了面积的浪费(见下图右侧)。
据《日经亚洲》报道,由于AI带来的计算需求激增,台积电正在探索510㎜ × 515㎜的矩形基板。
矩形基板的有效面积比圆形晶圆大三倍以上,有望显著提升台积电的生产能力。
然而,与圆形基板相比,方形基板存在光刻胶涂布不均匀和易碎裂的问题。
小摩指出,要实现PLP封装技术的大规模量产,仍需要数年时间的技术攻关。
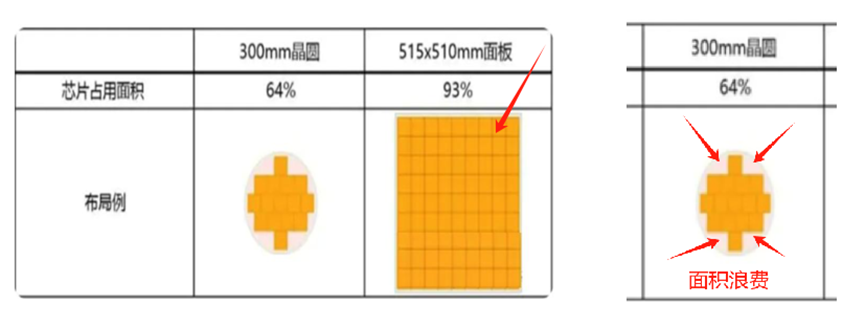
三、3D SoIC先进封装
3D SoIC是台积电开发的先进封装技术,专注于实现高密度的芯片垂直堆叠(相比之下,CoWoS技术主要是横向堆叠)。
小摩指出,目前3D SoIC技术在市场上还相对较为小众,只有AMD在其Ryzen 3D和MI300 AI加速器中采用。
预计从2025年下半年开始,台积电将逐步增加3D SoIC的产能。到2025年底,预计每月的3D SoIC产能将达到大约12,000到14,000片晶圆;到2026年底,预计将增至每月20,000片晶圆。
此外,小摩推测,英伟达的Rubin架构以及苹果的M5处理器可能会采用3D SoIC技术。
编辑/Somer
未经允许不得转载:新聚网 » 觀點 | 台積電的先進封裝怎麼樣了?

 新聚网
新聚网 本週美股牛股 | 幣圈利好頻傳!Coinbase周累漲超22%,加密監管指引將被撤銷;生物製藥公司SMMT今年累漲超105%,最新肺癌藥物試驗取得積極成果
本週美股牛股 | 幣圈利好頻傳!Coinbase周累漲超22%,加密監管指引將被撤銷;生物製藥公司SMMT今年累漲超105%,最新肺癌藥物試驗取得積極成果 特朗普「變臉」黃金巨震!後續金價何去何從,需要留意什麼?
特朗普「變臉」黃金巨震!後續金價何去何從,需要留意什麼? 據港交所文件:滬上阿姨(上海)實業股份有限公司通過港交所上市聆訊。
據港交所文件:滬上阿姨(上海)實業股份有限公司通過港交所上市聆訊。 特朗普放棄撤換鮑威爾的原因:財長和商務部長緊急介入!
特朗普放棄撤換鮑威爾的原因:財長和商務部長緊急介入! 美股早市 | 特朗普關稅立場軟化!納指漲超3%,亞馬遜漲超7%,特斯拉、英偉達漲超4%;中概股全線飆升,小鵬漲超10%,拼多多漲超5%
美股早市 | 特朗普關稅立場軟化!納指漲超3%,亞馬遜漲超7%,特斯拉、英偉達漲超4%;中概股全線飆升,小鵬漲超10%,拼多多漲超5% 和多數人唱反調!渣打堅持預計本週25點子減息,列舉50點子預期七大質疑
和多數人唱反調!渣打堅持預計本週25點子減息,列舉50點子預期七大質疑






